

Product Center
Current Option:All Products
-

Hybrid Laminate Board6L
Hybrid Laminate Board6L
▪ Number of layers: 6 layers▪ Process: Immersion gold plating▪ Aspect ratio: 8:1▪ Finished product thickness: 1.6mm▪ Minimum hole diameter: 0.2mm▪ Line width/line spacing: 5mil/5mil▪ Technical point: FR4+Rogers 4350B hybrid pressing
Learn More > -

5 oz Power Board12L
5 oz Power Board12L
▪ Plate material: S1000-2m▪ Plate thickness: 4.5mm▪ Number of layers: 12 layers▪ Finished copper thickness: 4OZ for the inner layer, 5OZ for the outer layer▪ Smallest copper hole: 30um▪ Surface process: Immersion gold plating
Learn More > -

Rigid-Flex PCB6L
Rigid-Flex PCB6L
▪ Number of layers: 6 layers for hard board, 2 layers for soft board▪ Material: FR4+PI▪ Aspect ratio: 8:1▪ Finished product thickness: 1.6mm + 0.15mm▪ Minimum hole diameter: 0.2mm▪ Line width/line spacing: 4mil/4mil▪ Technical points:
Learn More > -

10l Half-Hole Board10L
10l Half-Hole Board10L
.Layers: 10 Layers.Material: Shengyi S1000-2M.Aspect Ratio: 8:1.Finished Thickness: 1.6mm.Minimum Hole Diameter: 0.2mm.Line Width/Spacing: 3mil/3mil.Surface Finish: ENIG (Electroless Nickel Immersion Gold).Technical Highlights: Half-hole, Minimum BGA Pitch 0.2mm
Learn More > -

FCBGA8L 3+2+3
FCBGA8L 3+2+3
·Layers -- 8L 3+2+3·Materials --MCL-E-705G+ABF GL102·Thickness --0.76mm·Size --50*50 mm·Inner-Copper -- 17um.Min line width/spacing --10/10um·Min aperture --50um·Surface treament一 IT+SOP
Learn More > -

RF4L 1+2+1
RF4L 1+2+1
◆ Structure: 4L,1+2+1,Total thickness:180μm min;◆ Layer alignment: blind via ring width 25μm,Adjacentlayer shift≤25μm,Random layer shift≤40μm◆ MSAP process,trace width tolerance ±5μm ;◆ Surface finish: Thin ENEPIG ( Ni thickness 0.3~0.5μm)
Learn More > -

AP/FCCSP2L
AP/FCCSP2L
◆ Structure : 2L,Total thickness170 μm, core thickness 100μm;◆ MSAP process,L/S=20/20μm◆ 75μm laser dirlled “X” hole ,copper filled.Bonding finger Pitch: 95μm(50/40μm)BOL Pitch: 55μm(25/30μm)◆ Surface finish:Soft Ni/Au+OSP +Etch-back
Learn More > -

AP/FCCSP6L 2+2+2
AP/FCCSP6L 2+2+2
◆ Structure : 6L, 2+2+2,Total thickness 400 μm, core thickness 150μm;Inner layer: 75μm laser dirlled“X” hole ,copper filled. Outer layer:60μmlaser blind via.◆ Fine line: inner layerMSAP process,L/S=15/15 μm.◆ AUS SR1/thickness 15+/-7μm,SRO=105μm,SM shift tolerance≤15...
Learn More > -

LPDDR3L
LPDDR3L
◆ Structure:3L Coreless, Total thickness:130μm;◆ MSAP process,BF Pitch/Width min /Space min :65/35/15μm;◆ Warpage≤2mm(before reflow);◆ Surface finish: AFOP(TOP:Ni/Au,BTM: OSP)
Learn More > -

SSD2L
SSD2L
◆ Structure: 2L,Total thickness:100 μm min;Mechanical Drilling,Filled Via with SM;Laser Drilling,Filled Via with Copper, dimple≤5μm;◆ Tenting process,L/S≥35/35um;MSAP process,L/S≤25/25μm;◆ SM colour: Green or Black matte /thickness 20+/-7μm,SM Flatness≤7μm;◆ Surface fini...
Learn More > -
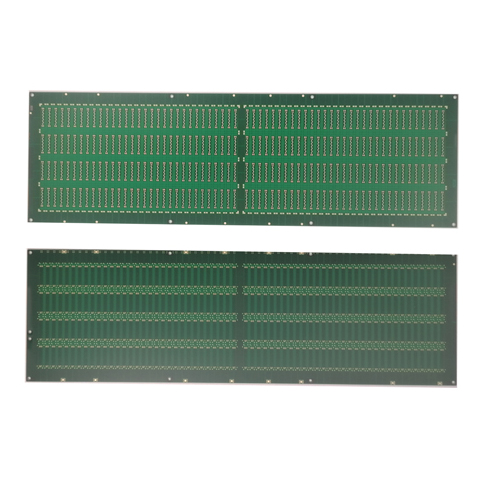
Touch Fingerprint2L
Touch Fingerprint2L
◆ Structure: 2L,Substrate thickness tolerance±15μm;Mechanical Drilling,Filled Via with SM or resin;◆ Tenting process,L/S≥35/35μm;◆ AUS320/25±7μm,SM Flatness≤7um;◆ Surface finish: Soft Ni/Au +Etch-back
Learn More > -

GPU12L 5+2+5
GPU12L 5+2+5
◆ Structure:12L,5+2+5◆ Core: BT / thickness 0.8mm◆ Bulid up : GX92/ thickness 25μm
Learn More >

